- 品牌
- 布鲁克
- 型号
- D8
RuO2薄膜掠入射XRD-GID引言薄膜材料就是厚度介于一个纳米到几个微米之间的单层或者多层材料。由于厚度比较薄,薄膜材通常依附于一定的衬底材料之上。常规的XRD测试,X射线的穿透深度一般在几个微米到几十个微米,这远远大于薄膜的厚度,导致薄膜的信号会受到衬底的影响(图1)。另外,如果衍射简单较高,那么X射线只能辐射到部分样品,无法利用整个样品的体积,衍射信号弱。薄膜掠入射衍射(GID:GrazingIncidenceX-RayDiffraction)很好的解绝了以上问题。所谓掠入射是指使X射线以非常小小的入射角(<5°)照射到薄膜上,小的入射角大大减小了在薄膜中的穿透深度,同时增加衍射颗粒的数目和x射线在薄膜中的光程。这里有两点说明:GID需要硬件配置;常规GID只适合多晶薄膜和非晶薄膜,不适合单晶外延膜。对较大300 mm的样品进行扫描、安装和扫描重量不超过5kg的样品、自动化接口。浙江购买XRD衍射仪

对于需要探索材料极限的工业金属样品,通常需要进行残余应力和织构测量。通过消除样品表面的拉应力或引起压应力,可延长其功能寿命。这可通过热处理或喷丸处理等物理工艺来完成。构成块状样品的微晶的取向,决定了裂纹的生长方式。而通过在材料中形成特定的织构,可显着增强其特性。这两种技术在优化制造法(例如增材制造)领域也占有一席之地。由于具有出色的适应能力,使用D8ADVANCE,您就可对所有类型的样品进行测量:从液体到粉末、从薄膜到固体块状物。浙江点阵参数精确测量XRD衍射仪推荐咨询使用DIFFRAC.EVA,测定小区域结构特性。通过积分2D图像,进行1D扫描,来进行定性相分析和微观结构分析。
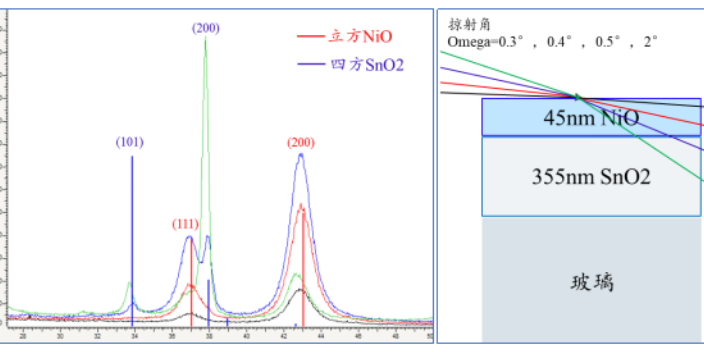
X射线反射率测定引言X射线反射率(XRR:X-RayReflectivity)是一种表面表征技术,是利用X射线在不同物质表面或界面的反射线之间的干涉现象分析薄膜或多层膜结构的工具。通过分析XRR图谱(图1)可以确定各层薄膜的密度、膜厚、粗糙度等结构参数。XRR的特点:1无损检测2对样品的结晶状态没有要求,不论是单晶膜、多晶膜还是非晶膜均可以进行测试3XRR适用于纳米薄膜,要求厚度小于500nm4晶面膜,表面粗糙度一般不超过5nm5多层膜之间要求有密度差
EIGER2R具有多模式功能(0D-1D-2D、快照和扫描模式),覆盖了从粉末研究到材料研究的多种测量方法。EIGER2并非传统意义上的万金油,而是所有分析应用领域的专业用户。其可实现无吸收测量的动态范围、用于超快粉末测量和快速倒易空间扫描的1D大尺寸以及超过500k像素的2D大覆盖范围,都为多模式探测器树立了新标准。EIGER2采用了DECTRIS公司研发的光束探测器技术,整合了布鲁克的软件和硬件,可为您带来无缝易用的解决方案。由于具有出色的适应能力,使用D8ADVANCE,您就可对所有类型的样品进行测量:从液体到粉末、从薄膜到固体块状物。UMC样品台通常用于分析大块样品、扫描测量应用和涂层分析,也能测量多个小样品或用于执行非环境实验。

药物制剂生产过程中除需添加各种辅料外,往往还需要经过溶解、研磨、干燥(温度)、压片等工艺过程,在此过程中API的晶型有可能发生改变,进而可能影响到药物的疗效。国内外FDA规定多晶型药物在研制、生产、贮存过程中必须保证其晶型的一致性,固体制剂中使用的晶型物质应该与API晶型一致。因此药物制剂中的晶型分析是非常重要的。由于辅料的存在对药物制剂中API的晶型分析增加了干扰,特别是API含量非常少的制剂样品,检测更加困难。XRPD是API晶型分析的有效手段之一,配合高性能的先进检测器,为制剂中微量API的晶型检测提供了有利工具。配备了UMC样品台的DISCOVER,优势在于对大型机械零件残余应力和织构分析以及残余奥氏体或高温合金表征。珠海布鲁克XRD衍射仪哪里好
根据应用需求,调节探测器的位置和方向,包括0°/ 90°免工具切换以及探测器位置可连续变化、支持自动对光。浙江购买XRD衍射仪
薄膜和涂层分析采用的原理与XRPD相同,不过进一步提供了光束调节和角度控制功能。典型示例包括但不限于相鉴定、晶体质量、残余应力、织构分析、厚度测定以及组分与应变分析。在对薄膜和涂层进行分析时,着重对厚度在nm和µm之间的层状材料进行特性分析(从非晶和多晶涂层到外延生长薄膜)。D8ADVANCE和DIFFRAC.SUITE软件可进行以下高质量的薄膜分析:掠入射衍射X射线反射法高分辨率X射线衍射倒易空间扫描。由于具有出色的适应能力,使用D8ADVANCE,您就可对所有类型的样品进行测量:从液体到粉末、从薄膜到固体块状物。无论是新手用户还是专业用户,都可简单快捷、不出错地对配置进行更改。这都是通过布鲁克独特的DAVINCI设计实现的:配置仪器时,免工具、免准直,同时还受到自动化的实时组件识别与验证的支持。浙江购买XRD衍射仪
蒙脱石散及杂质的鉴定引言蒙脱石散常见的用于用于成人及儿童急、慢性腹泻的药物。蒙脱石散的主要成分为层状结构的粘土矿物蒙脱石。根据中国药典,蒙脱石散的鉴别和杂质含量的分析的主要手段为XRD。不论在何种应用场合,它都是值得您选择的探测器:高的计数率、动态范围和能量分辨率。布鲁克提供基于NIST标样刚玉(SRM1976c)整个角度范围内的准直保证。D8衍射仪系列平台的D8ADVANCE,是所有X射线粉末衍射和散射应用的理想之选,如:典型的X射线粉末衍射(XRD)对分布函数(PDF)分析小角X射线散射(SAXS)和广角X射线散射(WAXS)XRD可研究材料的结构和物理特性,是 重要的材料研究工具之一。浙...
- 北京购买XRD衍射仪 2026-02-26
- 苏州GaN检测分析 2026-02-25
- 深圳微观应变分析XRD衍射仪 2026-02-25
- 上海微观应变分析XRD衍射仪配件 2026-02-25
- 布鲁克XRD衍射仪要多少钱 2026-02-25
- 北京布鲁克XRD衍射仪 2026-02-25
- 四川检测XRD衍射仪 2026-02-25
- 福建XRD衍射仪检测 2026-02-25
- 湖北物相定量分析XRD衍射仪配件 2026-02-25
- 江西全新XRD衍射仪推荐咨询 2026-02-25
- 实验室检测XRD衍射仪用户体验 2026-02-24
- 上海原位分析XRD衍射仪 2026-02-24
- 天津实验室检测XRD衍射仪 2026-02-24
- 浙江微观应变分析XRD衍射仪检测 2026-02-24
- 珠海布鲁克XRD衍射仪哪里好 2026-02-24
- 合肥粉末衍射检测分析 2026-02-24


- 福建布鲁克显微CT 02-25
- 上海孔隙度分析显微CT哪里好 02-25
- 苏州GaN检测分析 02-25
- 深圳微观应变分析XRD衍射仪 02-25
- 上海微观应变分析XRD衍射仪配件 02-25
- 布鲁克XRD衍射仪要多少钱 02-25
- 辽宁BRUKER显微CT配件 02-25
- 江西布鲁克显微CT哪里好 02-25
- 药物有效成分分布 02-25
- 重庆布鲁克显微CT推荐咨询 02-25